



去胶工艺是微加工工艺过程中一个非常重要的工艺环节。在光刻工艺之后,我们往往需要面临显影后的底胶去除或者干法蚀刻工艺后变性的光刻胶的去除工作,这些环节中光刻胶去除的是否干净以及对样片是否有损伤等将直接影响到后续工艺的进行以及器件的性能。德国ALPHA PLAMSA拥有多年的微波等离子去胶机设计制造历史以及丰富去胶经验,致力于为您提供专业的微波等离子去胶机系统,并提供专业的技术支持服务。

| 工艺腔室:石英 |
| 腔室容量:6升 |
| 腔室尺寸:φ150 ×260mm |
| 样品尺寸:4寸,向下兼容 |
| 腔门:抽屉式,带观察窗 |
| 微 波 源:2.45GHz,50-600W可调 |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:pirani,1-1×105Pa |
| 真 空 泵:干泵, XDS35i BOC Edwards |
| 真 空 阀:电子气动阀 |
| 控制系统:7寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配法拉第笼 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:500(W)× 550(D)× 370(H)mm |
| 工艺腔室:石英 |
| 腔室容量:11升 |
| 腔室尺寸:φ240 ×260mm |
| 样品尺寸:6寸,向下兼容(最大可支持8寸) |
| 腔门:抽屉式,带观察窗 |
| 微 波 源:2.45GHz,50-600W可调 |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:pirani,1-1×105Pa |
| 真 空 泵:干泵, XDS35i BOC Edwards |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配高温、温控盘或法拉第笼 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:620(W)× 550(D)× 500(H)mm |


| 工艺腔室:石英 |
| 腔室容量:21升 |
| 腔室尺寸:φ240 ×460mm |
| 样品尺寸:6寸,向下兼容,最大可处理8寸样品 |
| 腔门:抽屉式,带观察窗 |
| 微 波 源:2.45GHz,50-1200W可调 |
| 气 路:标配三路工艺气体,带质量流量计 |
| 真 空 规:Baratron,1-1,000Pa |
| 真 空 泵:干泵, XDS35i BOC Edwards |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配高温、温控盘或法拉第笼电 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:760(W)× 775(D)× 775(H)mm |
| 工艺腔室:铝 |
| 腔室容量:10升 |
| 腔室尺寸:250(W)× 250(D)× 170(H)mm |
| 样品尺寸:6寸,向下兼容,最大可处理8寸样品 |
| 腔门:抽屉式带加热台盘60-200℃,带观察窗 |
| 微 波 源:2.45GHz,最大1200W |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:Pirani |
| 真 空 泵:干泵或者油泵可选 |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配250℃加热台盘 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:450(W)× 640(D)× 725(H)mm |


| 工艺腔室:铝 |
| 腔室容量:20升 |
| 腔室尺寸:350(W)× 350(D)× 170(H)mm |
| 样品尺寸:12寸,向下兼容 |
| 腔门:抽屉式带加热台盘60-200℃,带观察窗 |
| 微 波 源:2.45GHz,最大1200W |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:Pirani, PCR280 Standard |
| 真 空 泵:干泵或者油泵可选 |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配250℃加热台盘 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:560(W)× 770(D)× 770(H)mm |
| 工艺腔室:铝 |
| 腔室容量:10升 |
| 腔室尺寸:250(W)× 250(D)× 170(H)mm |
| 样品尺寸:6寸,向下兼容 |
| 腔门:抽屉式带加热台盘60-200℃,带观察窗 |
| 微 波 源:2.45GHz,最大1200W |
| 气 路:标配三路工艺气体,带质量流量计 |
| 真 空 规:Pirani |
| 真 空 泵:抽速60m3/h,干泵或者油泵可选 |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,带机械手臂、中心校准、进出料盒平台 |
| 选 配 件:气路(可升级至4路),选配250℃加热台盘 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:920(W)× 1200(D)× 1200(H)mm |

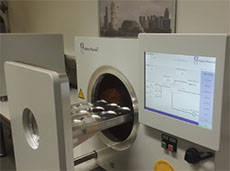
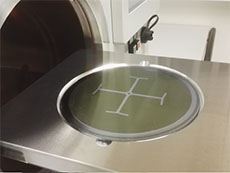


去胶机作为微纳米加工的基础设备之一,在微纳米技术及加工中有着丰富的应用场景,本文将针对微纳米加工中常见的几个去胶场景进行简单的介绍,旨在为从事为纳米加工或者从事微纳结构设计相关行业的技术人员提供一些方法和思路,如果您也有相关的需求,不妨跟我们来一起了解一下吧!
产品优势:
应用领域:

首先,让我们回顾一下一般光刻过程(如下图所示),我们会发现,整个光刻过程中都是围绕着光刻胶来进行的,但是光刻胶本身在微纳米加工过程中只是媒介而已,在往往在图形转移后我们都是需要将光刻胶去除的,不同的图形转移工艺对应的光刻胶特性也是不同的,去胶的工艺也会有很大的不同,例如,金属剥离工艺中(lift-off)我们通常会选择湿法去胶工艺,但是在干法刻蚀、离子注入、电铸工艺后我们往往会选择干法去胶或者湿法与干法结合来完成去胶。
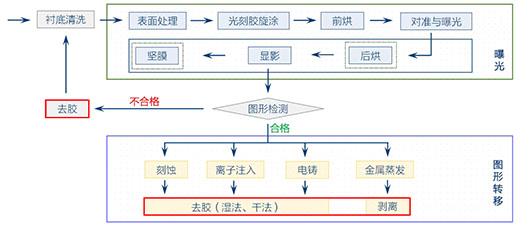
除一些特殊的工艺中光刻胶保留在结构中外,其他的工艺过程之后需要去除光刻胶,湿法去胶操作简单便捷,几乎没有设备要求,在实验室更受欢迎,而在图形转移工艺之后,光刻胶不可避免的会受到温度、离子注入等因素的影响导致光刻胶变得更加稳定或者光刻胶变性导致无法使用湿法完成去胶。因此氧等离子去胶是微纳加工中必要的基础设备之一。
等离子去胶是利用氧气在微波发生器的作用下产生氧等离子体,具有活性的氧等离子体与有机聚合物发生氧化反应,使得有机聚合物被氧化成水汽和二氧化碳等排除腔室,从而达到去除光刻胶的目的,这个过程我们有时候也称之为灰化。氧等离子去胶相比于湿法去胶工艺更为简单、适应性更好,去胶过程纯干法工艺,无液体或者有机溶剂参与。当然我们需要注意的是,这里并不是说氧等离子去胶工艺100%好于湿法去胶,同时也不是所有的光刻胶都适用于氧等离子去胶,以下几种情形我们需要注意:
我们刚才讨论过,图形转移后除剥离(Lift-off)工艺的去胶外几乎都会用到氧等离子去胶,虽然剥离工艺的去胶不会用到氧等离子去胶,但是,氧等离子去胶机在剥离工艺前却扮演者重要的作用 ——打底胶。
打底胶工艺是指利用氧等离子体去除光刻显影后结构底部残留的一层薄薄的底胶,这层底胶往往非常薄,但是尽管他非常薄但是也会导致后续蒸发的金属与衬底之间无法形成欧姆接触,甚至形成很大的接触电阻,导致器件性能不佳。如下图所示:

打底胶所需要去除的光刻胶层非常薄,所以不需要很长的时间即可完成,为了增加等离子体的均匀性,比并进一步降低等离子体的激子密度,我们会选择使用法拉第笼来配合实现这一工艺。打底胶工艺需要注意,等离子体在灰化掉底胶的同时本来应该保留的光刻胶也会被灰化掉一层,如果光刻胶被灰化的比较严重,会导致光刻胶的上表面轮廓变圆或者光刻胶变成顶切形态,这些都会导致后续的剥离工艺发生困难。如下图所示过度打底胶后的光刻胶轮廓:
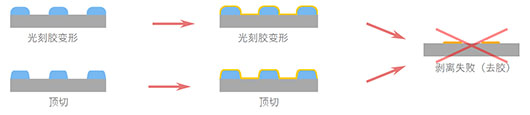
众所周知,SU-8以一款非常经典的紫外负胶,以其厚度范围宽泛、稳定性好以及机械稳定性好等特点著称,其热稳定性可以高达300多摄氏度,因为被广泛应用于MEMS、电铸模具加工、微流控芯片加工等众多应用领域。PI(聚酰亚胺)胶也有类似的性能,其虽然没有SU-8胶拥有很大的厚度范围,但是其可耐受高达450℃的高温条件,在很多后续需要高温镀膜或者高温工艺的工艺场合非常受欢迎,如热电堆型红外探测器芯片中的牺牲层。其实,我们不难想到,稳定性越好的光刻胶其去胶的难度也会越大,不仅是湿法去胶,及使是干法的氧等离子去胶速度也不会特别高,所以我们必须使用加热以及使用氟基气体来加速去胶过程。而针对去胶过程中的加热,Alpha Plasma拥有高温样品台来应对这种需要高温的去胶工艺。下图是70um厚度的SU-8光刻胶去胶前后的实物图。
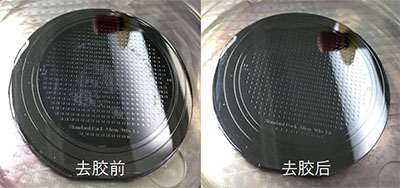
MEMS应用中,需要悬空结构的工艺都需要借助牺牲层技术来实现。PI聚酰亚胺是牺牲层工艺中常用的光刻胶,在PI聚酰亚胺去除的工艺中,要求完全去除牺牲层内的光刻胶,等离子具有良好的均匀性,对于样品的悬臂梁没有损伤。因此,牺牲层的去除往往比单纯去除裸露的光刻胶更加复杂和困难。

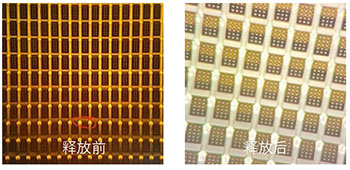
干法刻蚀以及离子注入是常见的半导体加工工艺之一,但是由于干法刻蚀以及离子注入会导致光刻胶发生变性甚至碳化,这种变性的光刻胶是无法用湿法工艺完成去胶,干法去胶可以有效去除这种变性的光刻胶。
除此之外,氧等离子体也可以用于样品的表面清洗、PDMS表面处理修饰等应用。